2020-12-05 10:51:57 责任编辑: 外延工艺供气管道系统工程公司 0
当今,随着时代的进步,社会已进入以半导体技术为核心的信息时代,在半导体制造生产过程中需要使用多种特殊气体,那么今天我们就来聊一聊在半导体制造生产中气体在半导体外延工艺中起到什么作用?
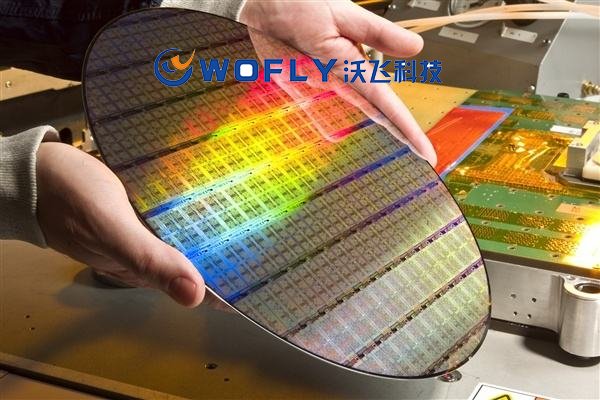
外延生长实际上主要是一个化学反应过程。硅外延生长使用的主要气源是氢气和氯硅烷类,如四氯化硅(SiCl4)、三氯甲硅烷(SiHCl3)和二氯甲硅烷(SiH2Cl2)。另外,为了降低生长温度,也经常使用硅烷作为气源。选择使用哪种气源主要由生长条件和外延层的规格来决定的,其中生长温度是选择气源种类时要考虑的最重要因素。硅外延层生长速度和生长温度的关系。图中显示了两个明显不同的生长区域,在低温区(区域A),硅外延层的生长速度和温度成指数关系,表明它们受表面反应控制;而在高温区(区域B),其生长速度和温度几乎没有直接的关系,表明它们受质量输运或者扩散的控制。需要着重指出的是,在低温条件下生长的硅薄膜为多晶层。硅外延层的形成温度在每条曲线的转折点以上,转折点的温度随着反应物的摩尔比、气流速度以及反应炉的种类变化而变化。从这张图中可以推断出:当以SiH4为气源时,硅外延层的形成温度大约在900℃,而以SiCl4为气源时,硅外延层的形成温度大约在1 100℃。
需要注意的是还原和腐蚀过程是相互竞争的,这主要决定于反应物的摩尔比和生长温度。在大气压下,以SiCl4和H2为反应物并在总压强为1.01×l05Pa(1大气压)的情况下,腐蚀和沉积的分界线与生长温度和SiCl4分压的关系。另外的研究也给出了以SiCl4和H2为硅外延的反应物时,生长速度和温度的关系,如图2.2-31表示。从图中可以看出在低温和高温下发生的是腐蚀过程。因此在这种情况下,外延温度通常选在1 100~1300℃。为了得到了较厚的外延层,通常会选择SiHCl3作为气源,主要是因为它的沉积速度比SiCl4的快。
SiCl4作为外延气源时所涉及的化学反应不同,采用SiH4气源时的热分解反应是不可逆的,其过程可以用、和其他任何氯硅烷相比,硅烷的主要优点是在相对较低的温度下可以得到硅外延层。但是由于硅烷的同质反应,很难避免硅的气相成核。因此在生长过程中将会形成硅颗粒,从而导致粗糙的表面形貌甚至是多晶生长。这个问题可以通过控制生长温度或者在低压生长而得到解决。硅烷是一种易于氧化和爆炸的气体,因此在传统的硅外延中,它不被经常使用。而且,在以硅烷为气源的生长过程中不存在HCl,因此不存在腐蚀这道工艺过程,从而导致外延层中含有更高浓度的金属杂质。因此,在使用硅烷作为外延气源时,需要采取非常仔细的预清洗工艺。
深圳沃飞科技有限公司成立于2011年,是一家专业从事气体系统工程设计安装、技术服务咨询和配套产品生产销售为一体的国家高新技术企业。公司拥有国家建筑机电安装工程专业承包资质、GC2压力管道设计安装资质,建筑施工安全生产许可证等专业资质。总部位于深圳,旗下有武汉子公司、香港子公司以及西安办事处。为客户提供大宗气体系统、电子特气系统、实验室气路系统、工业集中供气系统、洁净气体管道、高纯化学品供液系统、Local Scrubber尾气处理系统及机电项目安装等工程项目设计安装交钥匙式高性能和高质量的解决方案。工程项目覆盖半导体、集成电路、光电、新能源、微电子、光纤、生物医药、科研所、标准检测、高校院校等高技术领域行业。





